如今,半导体行业是一个庞然大物,其年销售收入超过了4,000亿美元。已有60多年的历史,这个成熟的行业尝试了各种模式,例如集成设备制造商(IDM),无晶圆厂(fabless)和代工概念,每种模型都采用了不同的知识产权(IP)策略。在1960年至1970年的早期阶段,设计集成电路是一项艰巨的任务,因为它需要专业的工程师,这些工程师在没有EDA工具的帮助下必须手动创建电路和布图。这将R&D限于少数能够负担得起此昂贵流程的制造商。那时,制造商的专利集中在产品的各个方面。
20世纪80年代初,EDA工具开始出现在市场上,导致流程的标准化,使更多的参与者能够进入制造领域。这种标准化有助于分割设计和制造过程;现在可以在一个地方设计,在另一个地方制造。由于制造变得极其昂贵,并且需要定期升级设备和工艺,因此这是一个巨大的解脱。这种分裂催生了各种分类,如IDM、fabless和代工。IDM包括资源最丰富的巨头,如德州仪器、英特尔和IBM。他们可以独立完成设计、制造、封装测试全套IC设计生产流程。此外还制造逻辑和存储器设备,这使得他们的产品组合拥有广泛的专利。图1描述了1990年德州仪器(TI)的4MB CMOS DRAM。该器件采用了沟槽电容进行数据存储。德州仪器公司不仅设计了该DRAM,而且还在美国自己的工厂制造了该器件并进行了全部封装。如今TI已经不再制造任何存储器产品,但它们仍在继续通过其庞大的知识产权资产获利。
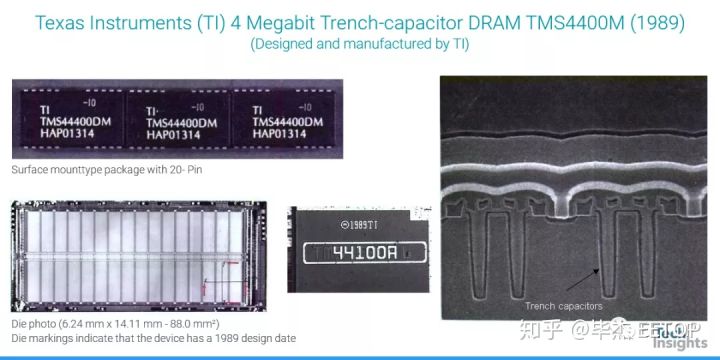
无晶圆厂模式采用自己设计产品,但依靠代工厂来制造的方式。因此,无晶圆厂公司仅专注于其产品可带入市场的功能和应用,而因此申请专利。高通公司是采用无晶圆厂模式的先驱者之一,这种模式直到今天仍然适用。图2用于比较高通不同时期得芯片,一张是90年代后期的,另一张是其最新器件之一。左侧的图像带有芯片标记,表明该芯片是由Intel制造的,右图是三星制造的。
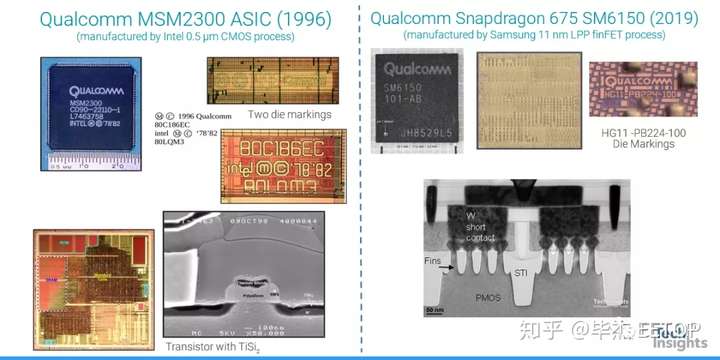
代工厂一直面临着制造挑战,例如缺陷密度,蚀刻选择性和高纵横比结构的填充,因此需要不断寻找解决方法。他们解决的每个主要问题都获得了专利。在接下来的10年中,无晶圆厂和代工厂的专利组合仍然相距甚远。随着时间的流逝,许多IDM退出了半导体行业或采用了无晶圆厂代工模式。维持整个半导体工艺的挑战需要巨大的资源和精湛的技术。
千年之交在半导体技术领域取得了长足的进步,包括IBM在1997年推出了铜互连,后来被所有其他逻辑制造商采用。铜互连通过Cu-Damascene结构的错位和电迁移问题带来了新的挑战,例如化学机械抛光铜和钽基阻挡层。解决了所有这些问题,并获得了来自不同制造商的大量工艺专利。这一时期还经历了摩尔定律的最高峰,该定律指出,芯片上的晶体管数量每两年翻一番,从而使制造电子设备的成本便宜得多。在此期间,制造了多种芯片用于多种应用。这些芯片安装在不同类型的印刷电路板上,并且根据输入/输出的数量,其配置可能会从引线键合,倒装芯片,针栅阵列,表面安装技术等变化。这些封装配置及其工艺差别很大,必须由一个完整的独立公司来承担。20世纪90年代末,外包组装测试(OSAT)应运而生。当时,无晶圆厂代工模式已经在亚洲建立了生产基地,而设计仍在美国和欧洲。OSAT将其传播范围进一步扩大到亚洲的其他国家。OSAT在测试设备和封装设备以及后端工艺专利方面做得非常出色。人们不应该忘记,少数IDM,他们紧盯着整个工艺,为封装行业的许多重要里程碑做出了贡献,如球栅阵列、倒装芯片铜柱工艺等。到了2000年代中期,有四个不同的组织(IDM、晶圆厂、无晶圆厂和OSAT)在开发自己独特的IP。
2007年推出的iPhone破坏了芯片生态系统的现状。组装在一起的智能手机占用的空间很小,包括显示屏、触摸屏、相机、麦克风、扬声器、电池、传感器、天线、Wi-Fi连接、内存、处理器、存储等,更不用说所有存在于日常操作中的不同类型的软件。随着智能手机的发展,创新的紧凑型封装,优化不同设备之间的互连结构以及为处理器提供强大的计算能力成为了迫切需要。智能手机将普通大众连接到互联网,使大量数据的传输成为可能,从而需要更好的数据收集和处理。数据组织需要市场上尚不可用的专用处理器。这种需求迫使公司满足这一需求。结果,设计公司,代工厂和软件公司之间的界限变得十分模糊:代工厂开始涉足设计和封装。尤其是作为领先的晶圆代工厂之一的台积电,更是将其产品组合扩展到了各个领域。如今,台积电为包括苹果在内的多家公司生产芯片,并开发了自己专有的集成扇出(InFO)封装技术,即把堆叠的DRAM裸片放置在嵌入式处理器的顶部,其成型化合物上有再分布线。图3是台积电最新推出的一款封装产品,主要用于苹果处理器。

同样,微软、苹果和谷歌等数据公司也开始为他们的应用设计芯片。这就造成了半导体工艺的重新整合;不同组织的融合导致了专利在组合交叉处的产生。未来,随着5G等技术的出现,来自不同团体的专利将更加混杂。
最近,我看到了一份关于5G的详细景观报告,由Drewent公司的Ed White介绍。其中一个主要的收获是,5G顶级受让方(三星、苹果、华为、高通、爱立信和诺基亚)的发明可以分为三十七个技术类别。这六家公司拥有41%的5G专利,而且他们都不具备任何制造能力(三星是个例外)。尽管如此,它们都申请了各种技术类别的专利,包括医疗、教育、农业、汽车、多种接入方案、天线和增强型移动宽带。如此广泛的产品组合表明,将一家公司归入一个单一的框框,并为其指定一个独特的专业领域是非常困难的。软件公司、IDM、晶圆厂和无晶圆厂都在整个不同的范围内申请专利。
考虑到在5G时代,某些现有配置将出现新的应用,情况变得更加复杂。例如,5G的一项杰出技术是大规模MIMO(多输入多输出)技术。MIMO被配置为允许无线网络通过单个无线电信道发送和接收多个数据信号。为了实现这一点,在同一平台上需要多个天线。结果,未来的智能手机将具有更复杂的天线结构。这个概念已经打开了一种新颖的封装应用,称为封装天线(AIP)或(AOP),它是嵌入式扇出封装的子集。嵌入式扇出封装的设计旨在在封装中集成有源和无源器件(例如天线,电感器和电容器)。英飞凌是嵌入式扇出封装的先驱之一,其嵌入式晶圆级球栅阵列(eWLB)于2008年开发,并授权给STATS ChipPAC、ASE和Amkor。这三家OSAT公司对原来的想法做了进一步的发展,提供了在封装中集成多种致动器和致动器的解决方案,包括天线结构;这鼓励了许多其他参与者加入扇出技术社区。当英飞凌于2019年为Google Pixel 4智能手机构建了精确的运动检测设备技术时,他们没有使用嵌入式扇出技术便做到了这一点。他们在印刷电路板中加入了天线。
除了分类界限消失外,知识产权(IP)不断易手的事实也使专利格局更加复杂。根据IAM编辑R.Lloyd的说法,2020年第一季度,美国专利交易数量最多,资产转手金额最大。事实上,自2010年对专利交易进行跟踪监测以来,2020年出现了最大的知识产权流动。IBM、LG和诺基亚是一些最主要的卖家,而大多数买家是非实践实体,然而台积电、三星和索尼是前五大买家之一。显然,半导体行业已经从一个DRAM专利只适用于特定产品的时代发展到了今天。今天,该技术仍然被分割成许多专业领域,但同时不同类别之间的接口比以往任何时候都更加流畅。由此产生的专利格局充满了挑战,但也为知识产权实践提供了机会。保护自己的知识产权没有单一的策略,一个可能的方法是接受开放创新的概念。开放式创新的主要理念是整合或接受来自外部组织的想法和技术,以增强自身的创新能力[7]。这使得半导体公司能够专注于自己的核心优势,并依靠与其他公司和/或研究联盟在其不具备所需技术的领域进行大规模合作。在此希望未来的知识产权注重创造力的出现,这也是半导体行业的特点。