英伟达联手SK海力士,尝试将 HBM 内存 3D 堆叠到 GPU 核心上
2023-11-20 08:04:54 IT之家11 月 20 日消息,据 Joongang.co.kr 报道,SK 海力士已经开始招聘逻辑半导体(如 CPU 和 GPU)设计人员,希望将 HBM4 通过 3D 堆叠的方式直接集成在芯片上。
据报道,SK 海力士正在与几家半导体公司讨论其 HBM4 集成设计方法,包括 Nvidia。
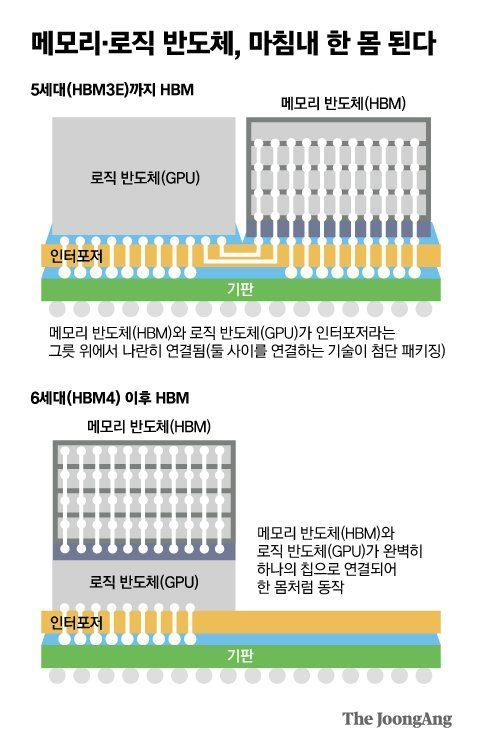
外媒认为,Nvidia 和 SK 海力士很可能会共同设计这种集成芯片,并借助台积电进行代工,然后通过台积电的晶圆键合技术将 SK 海力士的 HBM4 芯片堆叠到逻辑芯片上。而为了实现内存芯片和逻辑芯片的一体协同,联合设计是不可避免的。
如果 SK 海力士能够成功,这可能会在很大程度上改变行业的运作方式,因为这不仅会改变逻辑和存储新芯片的互连方式,还会改变它们的制造方式。

现阶段,HBM 堆叠主要是放置在 CPU 或 GPU 旁边的中介层上,并使用 1024bit 接口连接到逻辑芯片。SK 海力士的目标是将 HBM4 直接堆叠在逻辑芯片上,完全消除中介层。
在某种程度上来讲,这种方法有些类似于 AMD 的 3D V-Cache 堆叠,它就是直接将 L3 SRAM 缓存封装在 CPU 芯片上,而如果是 HBM 的话则可以实现更高的容量且更便宜(IT之家注:HBM 显然也会比缓存速度更慢)。
目前困扰业界的主要因素之一在于 HBM4 需要采用 2048bit 接口,因此 HBM4 的中介层非常复杂且成本高昂。因此,如果能够将内存和逻辑芯片堆叠到一起,这对于经济效益来说是可行的,但这同时又提出了另一个问题:散热。
现代逻辑芯片,如 Nvidia H100,由于配备了巨大的 HBM3 内存,在带来巨大 VRAM 带宽的同时也产生了数百瓦的热能。因此,要想为逻辑和内存封装集合体进行散热可能需要非常复杂的方法,甚至要考虑液冷和 / 或浸没式散热。
韩国科学技术院电气与电子工程系的教授 Kim Jung-ho 表示,“如果散热问题在两到三代之后解决,那么 HBM 和 GPU 将能够像一体一样运作,而无需中介层” 。
一位业内人士告诉 Joongang,“在未来 10 年内,半导体的 ' 游戏规则 ' 可能会发生变化,存储器和逻辑半导体之间的区别可能变得微不足道”。
免责声明:本文由作者原创。文章内容系作者个人观点,转载目的在于传递更多信息,并不代表EETOP赞同其观点和对其真实性负责。如涉及作品内容、版权和其它问题,请及时联系我们,我们将在第一时间删除!