三星电子成功研发3D 晶圆封装技术「X-Cube」,宣称此种垂直堆叠的封装方法,可用于7 纳米制程,能提高晶圆代工能力,要借此和业界领袖台积电一较高下。
三星官网13日新闻稿称,三星3D IC封装技术X-Cube,采用硅穿孔科技(through-silicon Via,TSV),能让速度和能效大跃进,以协助解决新一代应用程式严苛的表现需求,如5G、人工智能(AI)、高性能运算、移动和可穿戴装置等。
三星晶圆代工市场策略的资深副总Moonsoo Kang 说:「三星的新3D 整合技术,确保TSV 在先进的极紫外光(EUV)制程节点时,也能稳定联通」。有了X-Cube,IC 设计师打造符合自身需求的客制化解决方案时,将有更多弹性。X-Cube 的测试芯片,以7 纳米制程为基础,使用TSV 技术在逻辑晶粒(logic die)堆叠SRAM,可释放更多空间、塞入更多存储器。
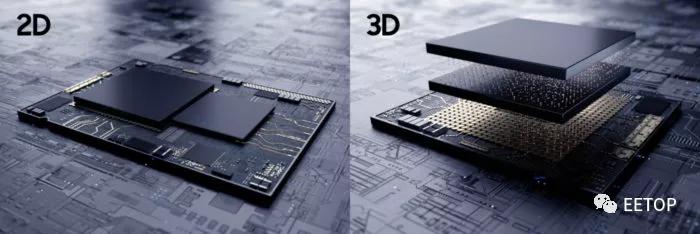
有了3D整合方案,晶粒间的讯号传输路径将大为缩短,可加快数据传送速度和能源效益。三星宣称,X-Cube可用于7纳米和5纳米制程。
韩国时报13 日报导,封装是晶圆生产的重要环节,过去几年来,三星强化封装技术,超薄封装能缩短积体电路的讯号传输路径,加快传递速度、提升能源效益。三星将在16~18 日的Hot Chips 峰会,公布更多X-Cube 的细节。