最近外媒Seeking Alpha发表了一篇文章“台积电正失去对英特尔的工艺领导地位”,
文中的主要观点如下:
文章链接:https://seekingalpha.com/article/4338843-taiwan-semiconductor-manufacturing-company-losing-process-leadership-to-intel
为此SemiWiki撰文进一步分析台积电、三星以及英特尔当前工艺技术以及未来发展,让我们看看台积电是否会被英特尔及三星超越。
原文链接:https://semiwiki.com/semiconductor-manufacturers/intel/285192-can-tsmc-maintain-their-process-technology-lead/
在深入研究公司之间的特定工艺密度比较之前,先澄清“Seeking Alpha”一文中有关“全栅极(GAA)和互补FET(CFET)”的误解。
正如业界从平面晶体管转向FinFET一样,一段时间以来人们就知道最终需要从FinFET过渡到其他产品以实现持续缩小。与仅在一侧具有栅极的平面晶体管相比,FinFET在三侧具有栅极,从而改善了器件通道的静电控制。改进的静电控制可降低沟道泄漏,并缩短栅极长度。FinFET还提供了一种3D晶体管结构,其单位面积的有效沟道宽度比平面晶体管的有效宽度宽,因此可提供更好的单位面积的驱动电流。
众所周知,FinFET之后的下一步就是水平纳米片(HNS)。如果纳米片非常窄,您会得到纳米线并显着改善静电。FinFET的栅极长度的近似极限为16nm,水平纳米线(HNW)的近似极限为13nm,请参见图1。较短的栅极长度是收缩接触式多晶硅(CPP)并推动更大密度的一个组成部分。
 图1
图1
HNW的问题在于有效沟道宽度小于相同区域中FinFET的有效沟道宽度。HNS的发展克服了这个问题,尽管可以牺牲一些静电控制来实现,但在相同区域内,FinFET的驱动电流可以达到1.26倍。
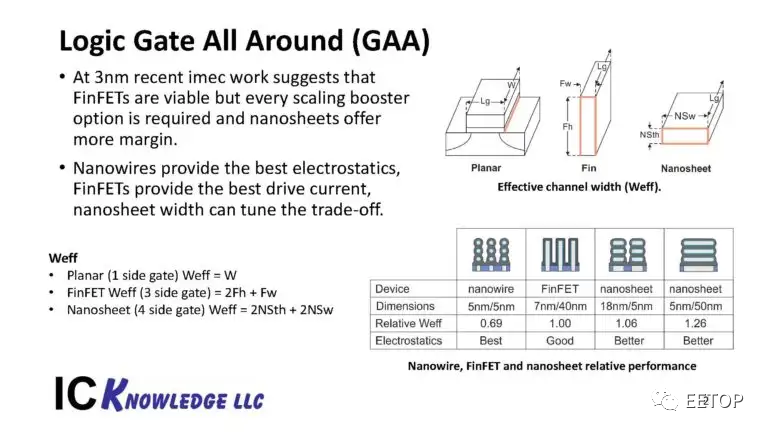 图2. 逻辑门(GAA)
图2. 逻辑门(GAA)
HNS的另一个优点是,该过程工艺就是FinFET工艺,只做了一些更改。这并不是要低估转换的难度,HNS的具体步骤是关键步骤,HNS的几何结构将使创建多个阈值电压变得困难,但这是FinFET技术的逻辑演进。设计人员习惯于使用具有4和5个阈值电压的FinFET,以最大程度地提高功率-性能折衷,回到一个或两个阈值电压将是一个问题,这仍然是HNS不断发展的领域。
在“ 3nm”节点上,三星宣布了一个名为“ Multibridge”的GAA HNS,另一方面,台积电仍在继续使用FinFET。两种技术都是3nm可行的选择,真正的问题应该是谁可以提供更好的工艺。
在Seeking Alpha的文章中,有一个关于CFET提供的密度是3鳍片FinFET单元的6倍的论述,但这不是它的工作原理,实际上,这种比较根本没有意义。
 来源:seekingalpha
来源:seekingalpha
逻辑设计是由标准单元组成的,标准单元的高度是由金属2间距(M2P)乘以轨道数给出的。最近的一个趋势是设计技术协同优化(DTCO),为了最大限度地缩小轨数,在M2P的同时,减少了轨数。在7.5轨单元中,每个晶体管通常有3个鳍片,但随着台积电的7nm和三星的5nm过渡到6轨单元,由于间距的限制,每个晶体管的鳍片被减少到2个。为了保持驱动电流,鳍片一般都会变高,并在其他方面进行优化。随着行业向5轨单元的发展,每个晶体管的鳍片将进一步减少到1。
逻辑设计由标准单元组成,标准单元的高度由金属2间距( metal 2 pitch M2P)乘以轨道数量得出。最近的趋势是设计技术协同优化(DTCO),以便最大程度地减少微缩,在M2P减少的同时,也减少了track的数量。在一个7.5 track cell中,每个晶体管通常具有3个鳍片,而在台积电(TSMC)7纳米和三星电子的5纳米,track cell已经过渡到6个,因此每个晶体管的鳍片减少到了2个。为了维持驱动电流,鳍片通常更高并且以其他方式被优化。随着行业转移到5个 track cell,每个晶体管的鳍片将进一步减少到1。
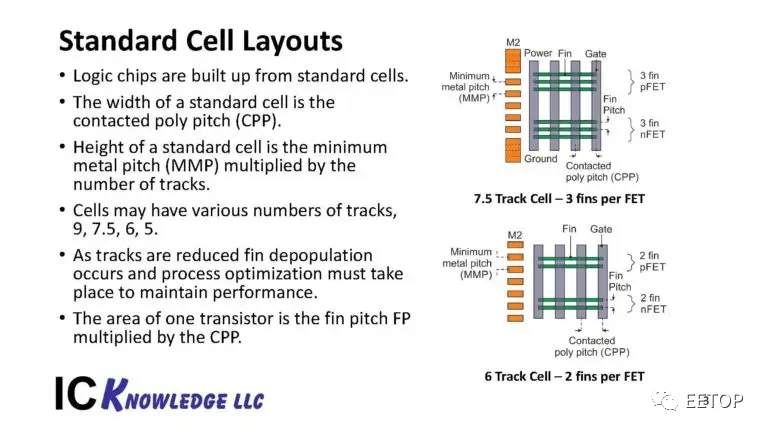 图3. 标准单元布局
图3. 标准单元布局
目前正在开发CFET,作为继续扩展到超越HNS的可能途径。在CFET中,nFET和pFET堆叠在一起,形成不同导电类型的水平纳米片。从理论上讲,CFET可以通过简单地堆叠越来越多的层而随时间变化,甚至可以放松光刻要求,但是要实现2层CFET仍然需要克服许多技术挑战。而且,由于从HNS到2层CFET的互连要求,密度增加了大约1.4倍至1.6倍,而不是预期的2倍。对于相同的工艺节点,2层CFET可能比优化的FinFET提供小于2倍的密度优势,而不是Seeking Alpha文章所要求的6倍。
2019年生产中领先的逻辑工艺是英特尔的10nm工艺,三星的7nm工艺和台积电的7nm光学工艺(7FF)。图5比较了这三个过程。
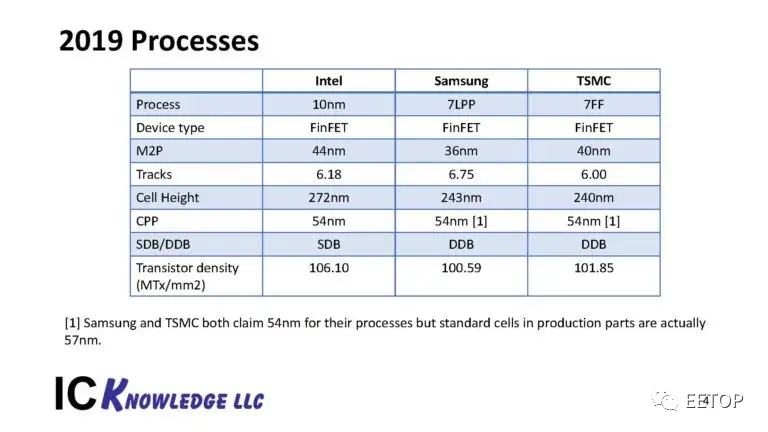 图4. 2019的工艺流程比较
图4. 2019的工艺流程比较
在图4中,M2P是 mental 2的间距,如前所述,tracks是track的数量,单元高度是M2P x Tracks。CPP是接触的poly pitch ,而SDB / DDB则代表该工艺是单扩散中断还是双扩散中断。标准单元的宽度是取决于单元类型的CPP数量,然后与单元边缘的SDB相比,DDB增加了额外的空间。晶体管密度是基于NAND单元和Scand Flip触发器单元以60%/ 40%权重混合而成的晶体管密度的加权平均值。在我看来,这是比较工艺密度的最佳指标,虽然不是完美的方法,但却使设计脱离了方程式。
这里应该注意的是,三星采用6nm工艺,而台积电采用7FFP工艺,都将晶体管密度提高到120MTx / mm 2左右。为了清楚起见,我将重点放在主要节点上。
2020年状态到2019年底,三星和台积电都开始风险试产5nm工艺,并且这两个工艺都将于2020年投入生产。
台积电真正在密度方面领先于5nm,台积电(TSMC)的5nm工艺的密度提高了1.84倍,而7nm却比三星的5nm工艺高了1.33倍。图5将英特尔的10nm工艺与三星和台积电的5nm工艺进行了比较,因为10nm仍是英特尔在2020年最密集的工艺。
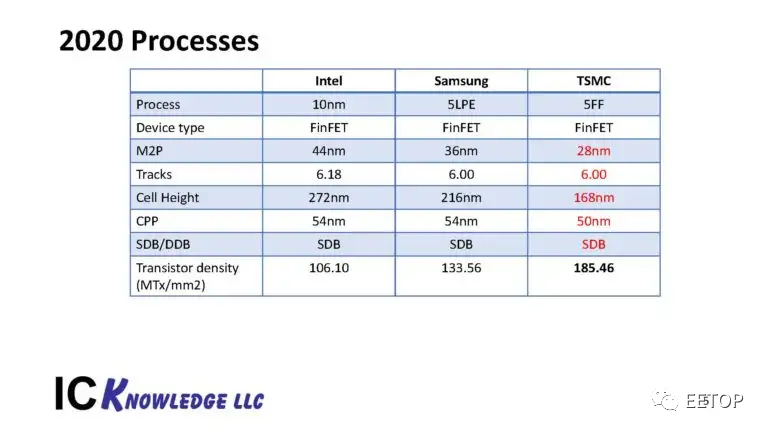 图5. 2020年工艺流程比较
图5. 2020年工艺流程比较
图5中三星的值是三星已确认的所有数字。台积电M2P是令人难以置信的28nm,这是我们在行业中听说的数字。其余数字是我们估计达到台积电所披露的密度改善目标的估计。
显然,台积电在2020年底的工艺密度领先于对手。
现在情况变得更加模糊,英特尔的7纳米制程将于2021年开始以2.0倍的微缩率开始增长。三星和台积电(TSMC)都将从2021年开始3nm风险试产。假设Intel可以完成计划,他们可能会短暂地具有生产密度优势,但是英特尔的14nm和10nm工艺都已经晚了几年。随着COVID 19冲击半导体产业,尤其是美国,这使我认为英特尔在2021年的可能性甚至更低。
图6比较了2021/2022流程,并假设在三个季度的正负1/4~2/3内都可用,我认为这是一个公平的假设。英特尔表示其密度将为10纳米的2.0倍,台积电在2020-Q1电话会议上表示3纳米将比5纳米高70%,因此大概是1.7倍,三星表示3纳米将晶粒尺寸相对于5纳米减少了35%,这相当于达到约1.54倍的密度。
为了使Intel的数字看上去合理,我假设有一个具有6条走线的激进的26nm M2P,一个针对FinFET和SDB的激进的47nm CPP。
对于三星,他们已经向SemiWiki公开了用于4nm的32nm M2P,我假设他们使用6 个tracks单元将其保持在3nm。对于使用GAA HNS的CPP,他们可以实现40nm和SDB。
对于台积电,他们将5纳米制程缩小了1.7倍,而7纳米制程缩小了1.84倍,而且还碰到了一些物理限制。由于性能原因,他们不希望CPP低于45nm,即使采用SDB,他们也必须非常积极地降低单元高度。通过实施掩埋式电源轨(BPR),他们可以进入5个 tracks 单元,BPR是一项新的困难技术,因此需要22nm的M2P。坦率地说,这么小的M2P会引起光刻和线路电阻方面的问题,而BPR也是激进的,因此我认为这一过程将具有极大的挑战性,但台积电在执行方面拥有出色的业绩。
图6总结了2021/2022过程图。
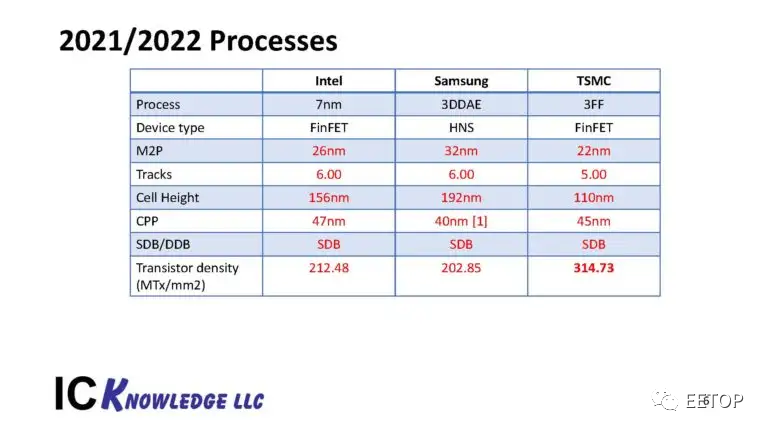 图6. 2021/2022流程
图6. 2021/2022流程
图6中的几个有趣的观察。尽管三星是第一个加入GAA的公司,但我们希望它们的工艺密度最小,而台积电和英特尔都将使用FinFET来提高工艺密度。三星可能做得比我们预期的要好,但我认为它们不会接近台积电的密度。另一个关键点是,尽管英特尔正在将10nm缩小2倍至7nm,但在大致相同的时间,台积电正在已1.84倍将7nm缩小至5nm,1.7倍将5nm缩小至3nm。坦率地说,我惊讶的是,台积电从5nm到3nm的密度提高了1.7倍,我期待的像是1.44倍,而5个tracks单元和22nm M2P都具有侵略性。我认为寻求Alpha表征台积电的3纳米缩小1.7倍是令人失望的,但它错过了在1.84倍之上达到1.7倍的要点,而且这种组合远远超出了其他任何人所能做的。
2021/2022之后的下一步我希望英特尔和台积电都采用HNS,而三星将生产第二代HNS。紧随其后的是,这三家公司将在2024/2025年左右实现CFET。
台积电今年以5nm制程制程密度处于领先地位。根据英特尔7nm制程与台积电3nm制程的确切时间,英特尔可能会短暂地重新获得制程密度领先优势,但台积电很快就会超过他们,因为他们的3nm制程每平方毫米有超过3亿个晶体管!